Latest Trends in Semiconductor Packaging Technology and Design & Evaluation Techniques for Semiconductor Encapsulation Materials
| ■ 発 行:2026年1月30日 ■ 著 者:野村 和宏 ■ 定 価:本体(冊子版) 88,000円(税込) 本体 + CD(PDF版) 110,000円(税込) ★ メルマガ会員:定価の10%引き! ■ 体 裁:A4判・並製・121頁 ■ 編集発行:㈱シーエムシー・リサーチ ISBN 978-4-910581-78-1 パンフレット |
 |
【テレワーク対応サービスのお知らせ】
弊社発行書籍を、書籍+CDのセットで弊社から直接お買い上げいただいたお客様には、ご希望があればCD中のPDF等を弊社URLからテレワーク先でもダウンロード可能な手配をいたします。ご希望の方は、発注時に合わせてご連絡ください。
購入方法
| カートへの投入、あるいはFAX申込用紙にてお申込ください。 | ||
| 本体(冊子版) | ||
| 本体+CD(PDF版) | ||
| FAX申込用紙PDF | ||
| [メルマガ登録者/新規登録希望者はこちらから] 弊社のメルマガ登録者は、代金が10%引きになります。メルマガ登録者/新規登録希望者の書籍購入は、下記のカートへの投入によってお申し込みください。また、FAX申込用紙でご注文の場合は、FAX申込用紙のメルマガ受信可否「受信する」にチェックをお願いします。 |
||
| 本体(冊子版) | ||
| 本体 + CD(PDF版) | ||
| FAX申込用紙PDF | ||
本書の特徴
➢ 半導体封止材の基礎から最新の技術動向まで、包括的に、また丁寧に解説!
➢ 封止材原料のエポキシ樹脂や硬化剤の情報、処方設計のためのコツ、製造工程の一例、信頼性評価、品質管理から最新のパッケージトレンドまで、幅広いトピックを紹介!
➢ 半導体封止材の開発実務経験者による失敗・成功体験を活かした実践的内容!
➢ 取材等を踏まえての最新研究開発および技術動向・今後の展望をご紹介!
➢ 学生・若手研究者から開発研究者・実務者まで必携の一冊!
= はじめに =
半導体は現代社会の基盤を支える最も重要な技術であり、通信機器、自動車、医療機器、産業機器に至るまで、あらゆる電子機器に組み込まれ、私たちの生活に無くてはならないものになっています。これらの半導体デバイスが過酷な環境下で長期にわたり安定した性能を発揮するためには、「半導体封止材」は必要不可欠な材料です。半導体封止材は、半導体チップを外部環境から守り、機械的強度を付与し、電気的特性を維持する役割を果たします。半導体封止材の品質が半導体デバイス全体の信頼性を左右すると言っても過言ではありません。高温・高湿度環境、熱サイクル、機械的衝撃といったストレスに耐え、さらには近年の5G通信、電気自動車、AIチップなどの高速化・高集積化に対応するため、更なる高耐熱化、低応力化、低誘電化など封止材には絶えず新たな技術革新が求められています。本書は、封止材の基礎から最新の技術動向まで、包括的に解説することを目的としています。封止材の原料となるエポキシ樹脂や硬化剤の情報、処方設計のためのコツ、製造工程の一例、信頼性評価、品質管理から最新のパッケージトレンドまで、幅広いトピックを取り上げました。執筆にあたっては、半導体封止材の開発に長年携わってきた中で失敗や成功の体験で得た知見と最新の研究開発動向の調査を踏まえ、実務に携わる技術者の方々にとって実践的な内容となるよう心がけました。同時に、これから半導体実装技術を学ぼうとする学生や若手研究者の方々にも理解しやすいよう、基礎的な内容から丁寧に説明しています。半導体技術は日々進化しており、それに伴い封止材技術も進化し続けています。ただ、現状においては出来る限り最新技術を網羅したつもりです。本書が、読者の皆様の業務や研究の一助となり、半導体封止材技術のさらなる発展に貢献できれば、著者としてこれ以上の喜びはありません。最後に、本書の執筆にあたり、図表の転載や引用の許可を頂きました企業や協会の皆様、最新の技術動向に関しまして、多くの貴重な情報を提供下さったカワサキテクノリサーチの斉藤氏、編集に関して多大なる御協力を頂きましたシーエムシー・リサーチの吉田氏、牧島氏に心より感謝申し上げます。
2026年1月 野村 和宏
2026年1月 野村 和宏
著 者
野村 和宏
1990年 京都工芸繊維大学 高分子学科 修士課程修了、
同年 長瀬チバ(現ナガセケムテックス)に入社
在職中は半導体封止材、絶縁封止材、CFRPマトリックス、各種接着剤などの変性エポキシ樹脂製品の開発業務に従事
2018年 ナガセケムテックスを退職、
2019年 NBリサーチ設立 封止材や接着剤に関する技術コンサルタント
内容見本
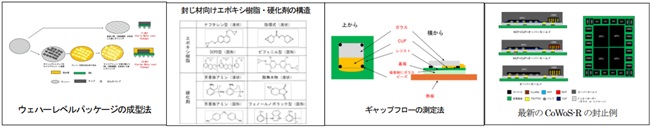
構成および内容
目次構成・内容一覧PDF
第1章 半導体デバイス
1. 集積回路(IC:Integrated Circuit)
1.1 ロジック
1.2 メモリー
1.3 アナログ
2. IC以外
2.1 オプト
2.2 パワー
2.3 センサー
参考文献
第2章 半導体パッケージ
1. ICパッケージ
1.1 デバイスが搭載される基材
1.2 基材との電気的接続
1.2.1 ワイヤーボンド
1.2.2 フリップチップ
1.2.3 ウェハーレベル
1.3 マザーボードとの接続
1.4 ICパッケージの進化
2. ICパッケージの成型法
2.1 ワイヤーボンドパッケージ
2.1.1 トランスファー成型
2.1.2 コンプレッション成型
2.1.3 ダム&フィル
2.1.4 グローブトップ
2.1.5 印刷法
2.2 フリップチップパッケージ
2.2.1 プレスバンプ(NCP/NCF)(先供給タイプ)
2.2.2 ノンフローアンダーフィル(NFUF)(先供給タイプ)
2.2.3 キャピラリーアンダーフィル(CUF)(後供給タイプ)
2.2.4 モールドアンダーフィル(MUF)(後供給タイプ)
2.3 ウェハーレベルパッケージ
2.3.1 FI-WLP (Fan-in Wefer Level Package)
2.3.2 FO-WLP (Fan-out Wefer Level Package)
参考文献
第3章 半導体封止材
1. 半導体封止材の原料
1.1 エポキシ樹脂
1.1.1 耐熱性エポキシ樹脂
1.1.2 柔軟性エポキシ樹脂
1.1.3 低分子エポキシ樹脂
1.2 硬化剤
1.2.1 アミン系硬化剤
(1)脂肪族アミン
(2)芳香族アミン
1.2.2 酸無水物
1.2.3 フェノール系硬化剤
1.2.4 潜在性硬化剤
1.2.5 UV硬化剤
1.3 添加剤
1.3.1 シランカップリング剤
1.3.2 消泡剤
1.3.3 分散剤
1.3.4 無機フィラー
1.3.5 応力緩和剤
1.3.6 顔料
1.4 原料起因の不具合例
1.4.1 硬化剤(酸無水物)の吸湿
1.4.2 硬化剤(アミン)の吸湿
1.4.3 酸無水物からの炭酸ガスの発生
1.4.4 粉体原料の凝集
1.4.5 金属不純物による反応性のばらつき
1.4.6 低分子シロキサンによる接点障害
2. 封止材の要求特性
2.1 ICパッケージ共通
2.1.1 耐湿性
2.1.2 耐熱性
2.1.3 高接着性
2.1.4 低応力特性
2.1.5 高純度
2.2 厚物パッケージ
2.2.1 難燃性
2.3 ワイヤータイプ
2.3.1 作業性
2.4 フリップチップ
2.4.1 作業性
3. IC封止材の設計
3.1 耐湿性
3.2 耐熱性
3.3 高接着性
3.4 低応力特性
3.4.1 低熱膨張
3.4.2 低弾性
3.5 高純度
3.5.1 イオン性不純物
3.5.2 放射性不純物
3.6 難燃性
3.7 作業性
3.7.1 チクソ性
3.7.2 狭ギャプフロー性
3.7.3 シート化
4. パワーデバイス封止材
4.1 パワーデバイスとは
4.2 パワーデバイス向け封止材の要求特性
4.3 パワーデバイス封止材の設計
4.3.1 熱エージング特性
(1)ビスマレイミド
(2)ベンゾオキサジン
(3)シアネートエステル
4.4 パワーデバイス向け封止材の製品特性
5. 封止材の製造
5.1 製造設備
5.1.1 アキシャルミキサー(固形封止材)
5.1.2 二軸混練押出機(固形封止材)
5.1.3 クラッシャー(固形封止材)
5.1.4 タブレットプレス(固形封止材)
5.1.5 プラネタリーミキサー(液状封止材)
5.1.6 トリミックス(液状封止材)
5.1.7 横型ニーダー(液状封止材)
5.1.8 三本ロール(液状封止材)
5.1.9 自転・公転ミキサー(液状実験用サンプル)
5.1.10 シリンジ充填装置(液状封止材)
5.2 製造工程
5.2.1 固形封止材
5.2.2 液状封止材
(1)製品の製造工程
(2)ベース製造工程
(3)固練り工程
(4)シリンジ充填工程
5.2.3 シート封止材
参考文献
第4章 封止材の評価
1. 外観
2. 作業性
2.1 流動性
2.1.1 スパイラルフロー
2.1.2 粘度
2.1.3 レオメーター
2.1.4 グローブハイト
2.1.5 ギャップフロー
2.2 反応性
2.2.1 ゲルタイム
2.2.2 イオン粘度
2.2.3 反応率
3. 熱特性
3.1 ガラス転移温度(Tg)(可逆的耐熱性)
3.2 熱分解温度(不可逆的耐熱性)
3.3 熱伝導率
3.3.1 ホットディスク法
3.3.2 レーザーディスク法
4. 耐湿特性
4.1 吸水率
5. 機械特性
5.1 熱膨張係数
5.2 弾性率
5.3 ダイシェアー強度
5.4 破壊靱性
6. 電気特性
6.1 体積抵抗率
6.2 誘電率・誘電正接
6.2.1 容量法(~1GHz)
6.2.2 ライン共振法(1-15GHz)
6.2.3 空洞共振法(1-40GHz)
7. 不純物
7.1 イオン性不純物
7.1.1 滴定法
7.1.2 原子吸光法
7.1.3 イオンクロマトグラフィー法
7.2 放射性不純物
8. パッケージ適正
8.1 はんだリフロー性(MSL)
8.1.1 吸湿条件
8.1.2 超音波探査装置(SAT)による剥離の確認
8.2 耐湿性(PCT,YHB)
8.2.1 吸湿条件
8.2.2 イオンマイグレーション
8.3 ヒートサイクル性(TCT)
参考文献
第5章 半導体封止材の今後
1. 先端パッケージング技術
1.1 2.1Dパッケージ
1.2 2.3Dパッケージ
1.3 2.5Dパッケージ
1.4 3Dパッケージ
2. 先端パッケージの封止技術
2.1 キャリアの大判化
2.1.1 生産性
2.1.2 反り
2.1.3 フローマークの問題
3. 高周波対応
3.1 伝送損失
3.2 化学構造と誘電特性
3.3 低誘電のための材料技術
3.3.1 PPEを硬化剤としたエポキシ樹脂
3.3.2 エポキシ樹脂への剛直な骨格の導入
3.3.3 分岐アルキル型エポキシ樹脂
3.3.4 活性エステル
3.4 低誘電封止材の開発
3.4.1 低誘電NCF
3.4.2 低誘電SMC
4. 熱対策
4.1 熱伝導の仕組み
4.2 熱伝導のための材料技術
4.2.1 セラミックフィラー
(1)アルミナ
(2)窒化ホウ素
(3)窒化アルミ
4.2.2 熱伝導高分子
4.3 高熱伝導封止材の開発
5. 省電力対策
5.1 リフロー温度の低温化
5.2 光電融合
5.2.1 取り組み
5.2.2 パッケージ
5.2.3 接続
(1)光ファイバーと光導波路
(2)ポリマー光導波路とPIC
(3)PICとEIC(Electronic IC)
5.2.4 変調
5.2.5 期待される有機材料
(1)封止材
(2)ポリマー光導波路
(3)EOポリマー
(4)ミラー
参考文献
謝辞
1. 集積回路(IC:Integrated Circuit)
1.1 ロジック
1.2 メモリー
1.3 アナログ
2. IC以外
2.1 オプト
2.2 パワー
2.3 センサー
参考文献
第2章 半導体パッケージ
1. ICパッケージ
1.1 デバイスが搭載される基材
1.2 基材との電気的接続
1.2.1 ワイヤーボンド
1.2.2 フリップチップ
1.2.3 ウェハーレベル
1.3 マザーボードとの接続
1.4 ICパッケージの進化
2. ICパッケージの成型法
2.1 ワイヤーボンドパッケージ
2.1.1 トランスファー成型
2.1.2 コンプレッション成型
2.1.3 ダム&フィル
2.1.4 グローブトップ
2.1.5 印刷法
2.2 フリップチップパッケージ
2.2.1 プレスバンプ(NCP/NCF)(先供給タイプ)
2.2.2 ノンフローアンダーフィル(NFUF)(先供給タイプ)
2.2.3 キャピラリーアンダーフィル(CUF)(後供給タイプ)
2.2.4 モールドアンダーフィル(MUF)(後供給タイプ)
2.3 ウェハーレベルパッケージ
2.3.1 FI-WLP (Fan-in Wefer Level Package)
2.3.2 FO-WLP (Fan-out Wefer Level Package)
参考文献
第3章 半導体封止材
1. 半導体封止材の原料
1.1 エポキシ樹脂
1.1.1 耐熱性エポキシ樹脂
1.1.2 柔軟性エポキシ樹脂
1.1.3 低分子エポキシ樹脂
1.2 硬化剤
1.2.1 アミン系硬化剤
(1)脂肪族アミン
(2)芳香族アミン
1.2.2 酸無水物
1.2.3 フェノール系硬化剤
1.2.4 潜在性硬化剤
1.2.5 UV硬化剤
1.3 添加剤
1.3.1 シランカップリング剤
1.3.2 消泡剤
1.3.3 分散剤
1.3.4 無機フィラー
1.3.5 応力緩和剤
1.3.6 顔料
1.4 原料起因の不具合例
1.4.1 硬化剤(酸無水物)の吸湿
1.4.2 硬化剤(アミン)の吸湿
1.4.3 酸無水物からの炭酸ガスの発生
1.4.4 粉体原料の凝集
1.4.5 金属不純物による反応性のばらつき
1.4.6 低分子シロキサンによる接点障害
2. 封止材の要求特性
2.1 ICパッケージ共通
2.1.1 耐湿性
2.1.2 耐熱性
2.1.3 高接着性
2.1.4 低応力特性
2.1.5 高純度
2.2 厚物パッケージ
2.2.1 難燃性
2.3 ワイヤータイプ
2.3.1 作業性
2.4 フリップチップ
2.4.1 作業性
3. IC封止材の設計
3.1 耐湿性
3.2 耐熱性
3.3 高接着性
3.4 低応力特性
3.4.1 低熱膨張
3.4.2 低弾性
3.5 高純度
3.5.1 イオン性不純物
3.5.2 放射性不純物
3.6 難燃性
3.7 作業性
3.7.1 チクソ性
3.7.2 狭ギャプフロー性
3.7.3 シート化
4. パワーデバイス封止材
4.1 パワーデバイスとは
4.2 パワーデバイス向け封止材の要求特性
4.3 パワーデバイス封止材の設計
4.3.1 熱エージング特性
(1)ビスマレイミド
(2)ベンゾオキサジン
(3)シアネートエステル
4.4 パワーデバイス向け封止材の製品特性
5. 封止材の製造
5.1 製造設備
5.1.1 アキシャルミキサー(固形封止材)
5.1.2 二軸混練押出機(固形封止材)
5.1.3 クラッシャー(固形封止材)
5.1.4 タブレットプレス(固形封止材)
5.1.5 プラネタリーミキサー(液状封止材)
5.1.6 トリミックス(液状封止材)
5.1.7 横型ニーダー(液状封止材)
5.1.8 三本ロール(液状封止材)
5.1.9 自転・公転ミキサー(液状実験用サンプル)
5.1.10 シリンジ充填装置(液状封止材)
5.2 製造工程
5.2.1 固形封止材
5.2.2 液状封止材
(1)製品の製造工程
(2)ベース製造工程
(3)固練り工程
(4)シリンジ充填工程
5.2.3 シート封止材
参考文献
第4章 封止材の評価
1. 外観
2. 作業性
2.1 流動性
2.1.1 スパイラルフロー
2.1.2 粘度
2.1.3 レオメーター
2.1.4 グローブハイト
2.1.5 ギャップフロー
2.2 反応性
2.2.1 ゲルタイム
2.2.2 イオン粘度
2.2.3 反応率
3. 熱特性
3.1 ガラス転移温度(Tg)(可逆的耐熱性)
3.2 熱分解温度(不可逆的耐熱性)
3.3 熱伝導率
3.3.1 ホットディスク法
3.3.2 レーザーディスク法
4. 耐湿特性
4.1 吸水率
5. 機械特性
5.1 熱膨張係数
5.2 弾性率
5.3 ダイシェアー強度
5.4 破壊靱性
6. 電気特性
6.1 体積抵抗率
6.2 誘電率・誘電正接
6.2.1 容量法(~1GHz)
6.2.2 ライン共振法(1-15GHz)
6.2.3 空洞共振法(1-40GHz)
7. 不純物
7.1 イオン性不純物
7.1.1 滴定法
7.1.2 原子吸光法
7.1.3 イオンクロマトグラフィー法
7.2 放射性不純物
8. パッケージ適正
8.1 はんだリフロー性(MSL)
8.1.1 吸湿条件
8.1.2 超音波探査装置(SAT)による剥離の確認
8.2 耐湿性(PCT,YHB)
8.2.1 吸湿条件
8.2.2 イオンマイグレーション
8.3 ヒートサイクル性(TCT)
参考文献
第5章 半導体封止材の今後
1. 先端パッケージング技術
1.1 2.1Dパッケージ
1.2 2.3Dパッケージ
1.3 2.5Dパッケージ
1.4 3Dパッケージ
2. 先端パッケージの封止技術
2.1 キャリアの大判化
2.1.1 生産性
2.1.2 反り
2.1.3 フローマークの問題
3. 高周波対応
3.1 伝送損失
3.2 化学構造と誘電特性
3.3 低誘電のための材料技術
3.3.1 PPEを硬化剤としたエポキシ樹脂
3.3.2 エポキシ樹脂への剛直な骨格の導入
3.3.3 分岐アルキル型エポキシ樹脂
3.3.4 活性エステル
3.4 低誘電封止材の開発
3.4.1 低誘電NCF
3.4.2 低誘電SMC
4. 熱対策
4.1 熱伝導の仕組み
4.2 熱伝導のための材料技術
4.2.1 セラミックフィラー
(1)アルミナ
(2)窒化ホウ素
(3)窒化アルミ
4.2.2 熱伝導高分子
4.3 高熱伝導封止材の開発
5. 省電力対策
5.1 リフロー温度の低温化
5.2 光電融合
5.2.1 取り組み
5.2.2 パッケージ
5.2.3 接続
(1)光ファイバーと光導波路
(2)ポリマー光導波路とPIC
(3)PICとEIC(Electronic IC)
5.2.4 変調
5.2.5 期待される有機材料
(1)封止材
(2)ポリマー光導波路
(3)EOポリマー
(4)ミラー
参考文献
謝辞

